ファイル:Illustration of C-V measurement.gif
ナビゲーションに移動
検索に移動
Illustration_of_C-V_measurement.gif (322 × 308 ピクセル、ファイルサイズ: 93キロバイト、MIME タイプ: image/gif、ループします、18 フレーム、5.4秒)
ファイルの履歴
過去の版のファイルを表示するには、その版の日時をクリックしてください。
| 日時 | サムネイル | 寸法 | 利用者 | コメント | |
|---|---|---|---|---|---|
| 現在の版 | 2010年5月17日 (月) 20:26 | 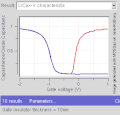 | 322 × 308 (93キロバイト) | wikimediacommons>Beatnik8983 | {{Information |Description={{en|1=C-V measurements can reveal oxide thickness, oxide charges, contamination from mobile ions, and interface trap density in wafer processes. In this image the C-V profile for a bulk p-type substrate MOSCAP with different ox |
ファイルの使用状況
以下のページがこのファイルを使用しています:
